L’équipement de dopage localisé par fusion laser ultra brève comprend un sas d’introduction, une chambre sous ultra-vide (UHV) et un banc optique qui focalise le faisceau d’un laser excimer XeCl (λ=308nm) sur l’échantillon.
Il sert essentiellement à doper des échantillons de Ge ou de Si en Bore ou en Phosphore.
Soit l’échantillon est placé dans la chambre de dopage avec un gaz précurseur (BCl3 ou PCl3) qui se chimisorbe à sa surface : on parle alors de GILD (Gas Immersion Laser Doping) soit l’échantillon a été au préalable préimplanté on parlera alors de PLIE (Pulsed Laser Induced Epitaxy).
Une impulsion (20-40ns) d’un laser UV de 308nm est envoyée sur la surface de l’échantillon et absorbée sur 7 nm. L’énergie lumineuse est intégralement et instantanément convertie en énergie thermique puisqu’il y a absorption directe des photons : leurs énergies 4eV étant supérieure au gap direct du Si et du Ge. Cette chaleur produite est évacuée très rapidement par diffusion unidimensionnelle vers le substrat. L’énergie thermique fait fondre le matériau à partir de sa surface sur une épaisseur entre 10 et 300nm. Les dopants diffusent de façon homogène dans la phase liquide. Lorsque la température locale est inférieure à la température de fusion, un front de recristallisation épitaxiale remonte jusqu’à la surface à une vitesse de l’ordre de 4 m/s suffisamment lent pour que le cristal se reconstruise à partir de la maille sous-jacente en l’absence de défauts et suffisamment rapide pour piéger en substitution les impuretés dopantes.

Le front de fusion progresse d’autant plus profondément dans le substrat que l’énergie laser absorbée est grande. Donc la densité d’énergie laser joue sur l’épaisseur dopée.
En GILD, si l’échantillon est placé sous un flux de gaz suffisant pour saturer la surface avant le tir laser, la quantité incorporée sera reproductible. Il suffira de renouveler autant que nécessaire la séquence fusion-recristallisation pour atteindre le taux de dopage recherché : Nombre de tirs laser détermine la concentration.
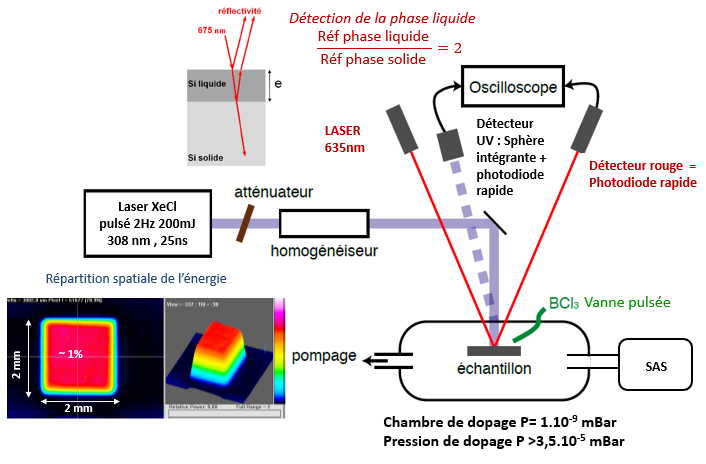
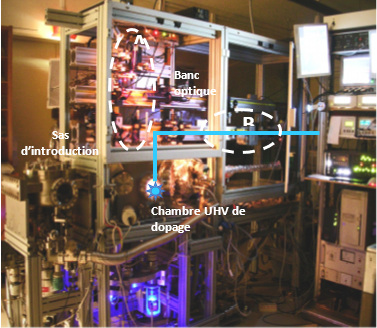
Avantages:
La supraconductivité du Si:B a été découverte en 2006 sur des couches ultra dopées fabriquées dans ce bâti GILD. Ce matériau s’inscrit dans la catégorie des supraconducteurs de type II covalents où, malgré la faible densité d’états, les liaisons covalentes entre atomes mènent à un potentiel de couplage électron-phonon Vel−ph fort tout en restant dans le cadre de la théorie BCS (Bardeen Cooper Schrieffer).
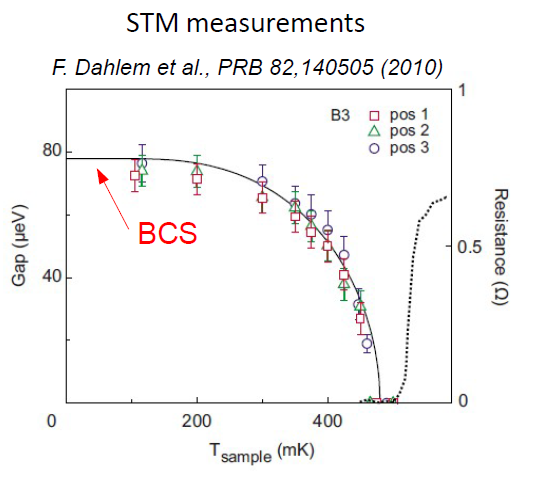
2 paramètres influencent la supraconductivité de Si:B :
La dose B = concentration * épaisseur = f(nombre de tirs laser) détermine la Tc et le seuil supraconducteur
La Théorie de bi-couche S/N (couche supraconductrice /couche métallique normale contenant moins de Bore à l’interface Si:B/Si) est à valider.

Applications:
→ transistor Josephson supraconducteur
→ MOSFET à barrière Schottky supraconducteur:
recuit laser MOSFET
supraconductivité dans une couche mince préimplante de 30 nm sur SOI ayant subi un recuit laser
supraconductivité dans les couches de SiGe dopées par GILD
→ Détecteurs de photons sensibles, gamme GHz (rayonnement de fond cosmologique, ...)
→ Propriétés intéressantes en Haute Fréquence en cours d’étude : non linéaires qui sont anormalement élevées

Applications:
L’électroluminescence est générée dans le substrat de Si sous les contacts ultra-dopés, aux longueurs d'onde caractéristiques de Si. Les angles d’émission sont relativement importants. On constate une augmentation de la luminescence avec le dopage et le rendement quantique externe est ~ 0,05 - 0,1%
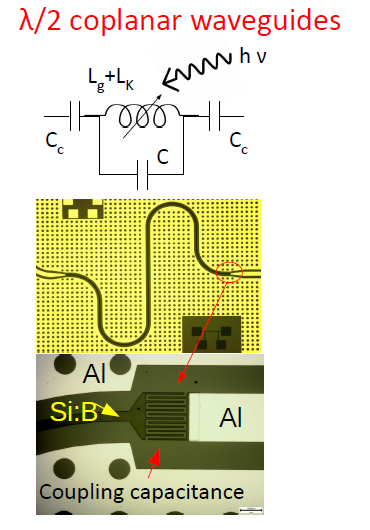
Par exemple, des contacts ohmiques jusqu'à 5 K sur des échantillons standards de n-dopée Ge ont été réalisés en créant une couche mince Ge fortement dopée entre les contacts métalliques et le substrat Ge grâce à l’utilisation du GILD. Des niveaux de dopage élevés au-dessus de la limite de solubilité ont été atteints et on a donc pu réduire la résistance de contact entre le Ge dopé et le métal.
Résultats: